圖1 一種容性耦合等離子體放電現象

由于刻蝕過程中復雜的物理和化學反應, 不同中性粒子、帶電粒子間的場(電場,流場,力場等)的相互作用,使得plasma刻蝕很難描述。一些文章中都是針對初學者簡單的介紹了等離子體刻蝕中的主要幾個過程,但是對于原理性的描述非常有限。Nasser, “Fundamentals of Gaseous Ionization and Plasma Electronics”, John Wiley & Sons, 1971,Chapman, “Glow Discharge Processes”, John Wiley & Sons, 1980兩本經典書籍全面的介紹了等離子體的基本物理定律和現象。物理和工程領域的相關人員可從此兩本書中了解等離子體技術。
容性耦合等離子體(CCP)
圖2 等離子體中的激發碰撞與光譜輻射
圖3 常用CCP源的腔室結構
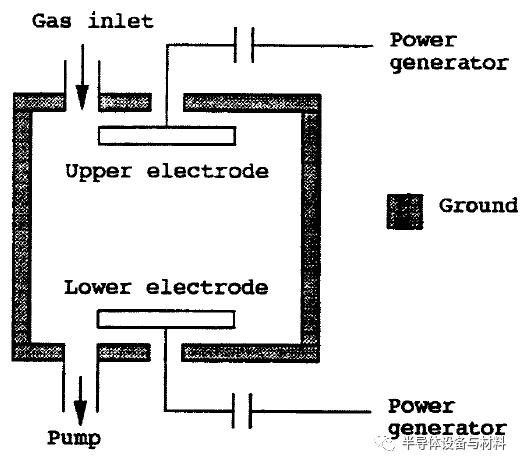
容性耦合等離子體放電氣壓范圍往往從幾個毫托到幾百毫托,因為電子質量遠低于離子質量,電子可以運動更遠更長的距離并與氣體和器壁進行碰撞,電離出更多的電子和離子。而器壁周圍因為電子游離只留下笨重的離子,但整個腔室必須保證電中性,故必然會在器壁形成一種結構來阻擋電子繼續在器壁周圍的電離,而這種結構平衡了等離子體的電中性特性。這種結構即鞘層,鞘層可認為前面所說的電容器,因為電容器處于放電環境中,表面有電荷積累,就形成了一個電場,一個電場必然對應一個電壓,因為電容器周圍達到的電荷積累動態平衡,故這個電場,電壓為動態的靜電場,即直流電場和直流電壓,故VDC形成。因為腔室內壁接地,而形成的偏壓電場為阻止電子,故對地內壁而言此VDC為負值,即負偏壓。在電極上此負偏壓與射頻電壓一起形成了復合電壓,如下圖。

2. 1VDC該公式可適用于任何電極結構,如果電極1加載功率,電極2接地,其VDC形成如下圖所示。
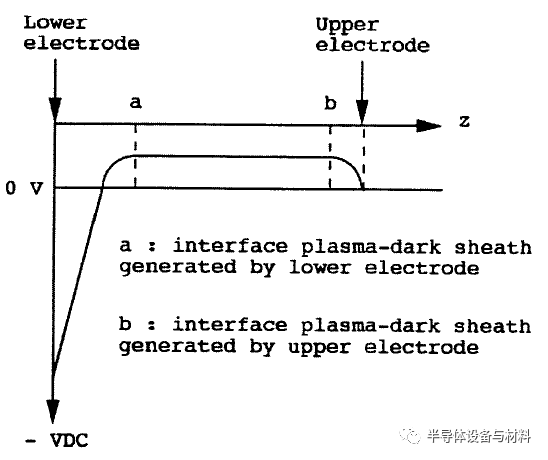
2.1.2.1 電負性氣體是一個主要因素,當其他過程參數保持一定時,氣體的電負特性將決定VDC。地電負性氣體如O2,N2有較高的負偏壓VDC,含F,Cl,Br的氣體有更強電負性,因為VII族的元素很容易吸附自由電子。因子在含F,Cl,Br的氣體中電子密度會大大降低。含F比含Cl氣體電負性更強, SF6為典型的電負性氣體。
2.1.2.2 氣壓也影響VDC,高氣壓,更多的分子、原子與電子碰撞,產生新的電子和離子,因此通過提高氣壓,增加更多的自由電子,提高了負偏壓。另一方面,氣壓增加,密度增加,電子的平均自由程降低,在和分子碰撞之前,電子獲得能量減小,導致新的電子、離子減少。因此兩個方面相反的趨勢,對于等離子體刻蝕,可以看到,1-100mT范圍內,等離子密度隨氣壓增加而增加,但更高的氣壓,密度隨氣壓增加而降低。VDC也與自由電子能量相關,高氣壓,電子碰撞增加,電子能量因碰撞而降低。考慮到這些機制,我們可以理解VDC隨氣壓增加并不會持續增加。
功率
2.1.2.4當Wafer放置在下電極上,可以在等離子體和Wafer之間得到較高的電壓降即VDC。當電負性氣體添加時,在低氣壓下,我們可以獲得高的電壓降VDC,對于高功率,RIE反應離子刻蝕,我們可以通過以上途徑獲得高VDC。如果要獲得低的VDC則從反方向條件著手。
刻蝕機制
通常,等離子體刻蝕是化學刻蝕,不是物理刻蝕,這意味著固體原子與氣體原子反應形成化學分子,然后從基片表面移除形成刻蝕。因為VDC的存在,通常存在一定的基片濺射,對于大量的刻蝕,物理刻蝕效應很弱可以被忽略。
1. 2. 3. 表面化學吸附反應,形成化學鍵,并形成反應產物;
解吸附化學反應產物,并在Wafer表面移除,抽離腔室;
圖6 等離子體刻蝕基本機制
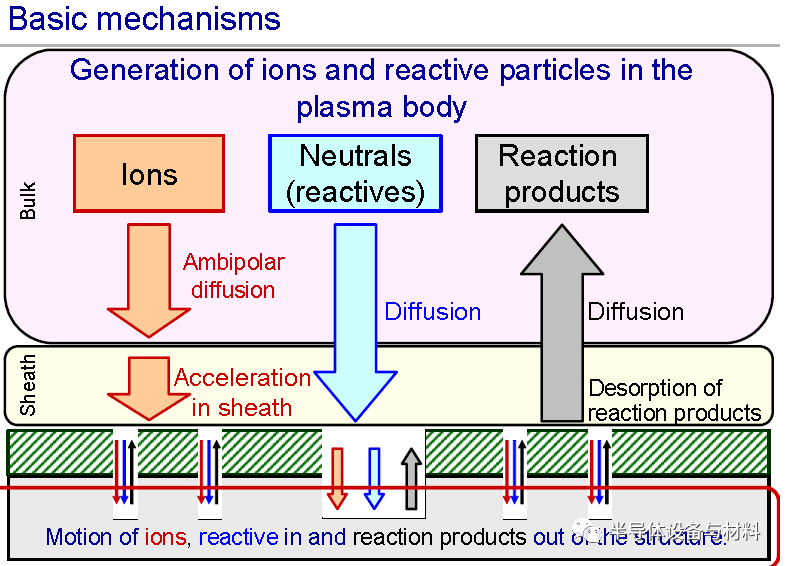
對刻蝕的影響
刻蝕速率,因為電子密度和能量與VDC相關聯,故以上的化學反應過程與速率相對應;
離子轟擊可以造成Wafer表面的建設損傷;而離子轟擊的能量與VDC相關,VDC越高轟擊越強;
離子轟擊還會對刻蝕形貌有一定的影響等等
對于非易揮發性副產物,通過一定的離子轟擊可以將副產物解離形成易揮發性產物,使本身在易在Wafer表面已形成的膜層消失;
圖7 離子轟擊作用

感應耦合等離子體(ICP)
兩種類型的感應耦合等離子體源:采用柱形和平面結構,如圖8所示。射頻電流流經線圈在腔室內產生電磁場激發氣體產生等離子體,偏壓源控制離子轟擊能量。通過這種方式,可以獨立的控制等離子體密度和離子的轟擊能量。因此ICP刻蝕機提供了更多的調控手段。
圖8 兩種方式的ICP結構
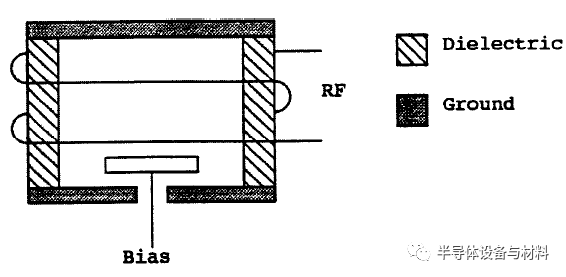
用于等離子體刻蝕的ICP源通常為平面結構,該方式容易獲得可調的等離子體密度和等離子體均勻性分布,此外平面ICP源使用的介質窗也易于加工。石英和陶瓷是常用的介質窗材料。
此外感應耦合ICP源也存在容性耦合,介質窗作為線圈和等離子體之間的耦合層是作為一個電容器存在,在線圈的輸出端電壓達到2000V時,容性耦合將會形成。這個容性高壓可以點燃和維持等離子體放電,另一方面,局部高壓的形成也會導致介質窗的刻蝕,導致顆粒的產生或者造成晶圓的污染。為了減小容性耦合,通常采用法拉第屏蔽或者在線圈末端串聯接地電容的方式。





